장비 안내
공정(process)명
E-beam lithography (전자빔 노광기)

| 모델명 | EBPG5150 Plus | Maker | RAITH |
|---|---|---|---|
| 담당자 | 문인용 | 연락처 | 031-299-4196 |
| q.fab@skku.edu | 상태 | (가동중) | |
| 장비 사양 |
|
||
| 공정 성능 |
|
||
○ (가능) / △ (협의 필요) / X (불가)
| 기판 종류 | 기판 Size | 기판 Type | 기판 두께 | ||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Si | Ⅲ-Ⅴ | Diamond | 조각 | 2” | 3” | 4” | 5” | 6” | 8” | 플랫 | 노치 | Normal | Special |
공정(process)명
Contact mask aligner (접촉식 마스크 노광기)

| 모델명 | MDA-400S | Maker | MIDAS |
|---|---|---|---|
| 담당자 | 문인용 | 연락처 | 031-299-4196 |
| q.fab@skku.edu | 상태 | (가동중) | |
| 장비 사양 |
|
||
| 공정 성능 |
Resolutions
|
||
○ (가능) / △ (협의 필요) / X (불가)
| 기판 종류 | 기판 Size | 기판 Type | 기판 두께 | ||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Si | Ⅲ-Ⅴ | Diamond | 조각 | 2” | 3” | 4” | 5” | 6” | 8” | 플랫 | 노치 | Normal | Special |
공정(process)명
Sputter (스퍼터 증착기)
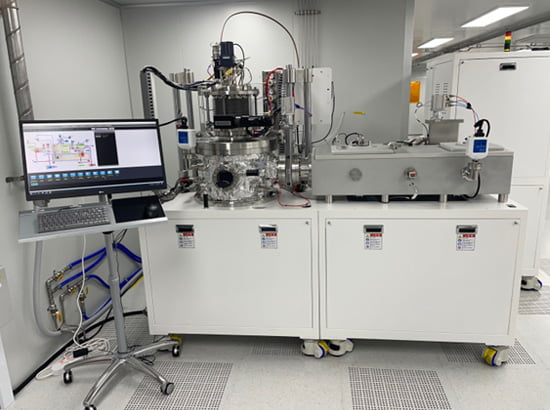
| 모델명 | 22KV6025 | Maker | Korea Vacuum Tech |
|---|---|---|---|
| 담당자 | 김평강 | 연락처 | 031-299-4196 |
| q.fab@skku.edu | 상태 | (가동중) | |
| 장비 사양 |
|
||
| 공정 성능 |
|
||
○ (가능) / △ (협의 필요) / X (불가)
| 기판 종류 | 기판 Size | 기판 Type | 기판 두께 | ||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Si | Ⅲ-Ⅴ | Diamond | 조각 | 2” | 3” | 4” | 5” | 6” | 8” | 플랫 | 노치 | Normal | Special |
공정(process)명
E-beam deposition (전극용 전자빔 증착기)

| 모델명 | 21KVS006 | Maker | Korea Vacuum Tech |
|---|---|---|---|
| 담당자 | 김평강 | 연락처 | 031-299-4196 |
| q.fab@skku.edu | 상태 | (가동중) | |
| 장비 사양 |
|
||
| 공정 성능 |
|
||
○ (가능) / △ (협의 필요) / X (불가)
| 기판 종류 | 기판 Size | 기판 Type | 기판 두께 | ||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Si | Ⅲ-Ⅴ | Diamond | 조각 | 2” | 3” | 4” | 5” | 6” | 8” | 플랫 | 노치 | Normal | Special |
공정(process)명
Vacuum annealing furnace (진공 어닐링 퍼니스)

| 모델명 | WEBB189 | Maker | R.D. WEBB Company |
|---|---|---|---|
| 담당자 | 김평강 | 연락처 | 031-299-4196 |
| q.fab@skku.edu | 상태 | (가동중) | |
| 장비 사양 |
|
||
| 공정 성능 |
|
||
○ (가능) / △ (협의 필요) / X (불가)
| 기판 종류 | 기판 Size | 기판 Type | 기판 두께 | ||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Si | Ⅲ-Ⅴ | Diamond | 조각 | 2” | 3” | 4” | 5” | 6” | 8” | 플랫 | 노치 | Normal | Special |
공정(process)명
I-line stepper (@KANC)

| 모델명 | I-line Stepper II(양자팹) (NSR-2005i10C) | ||
|---|---|---|---|
| Maker | NIKON | 담당자 | 김창환 |
| 연락처 | 031-546-6336 | changhwan.kim@kanc.re.kr | |
| 상태 | KANC에서 서비스 | ||
| 장비 사양 |
|
||
| 공정 성능 |
|
||
○ (가능) / △ (협의 필요) / X (불가)
| 기판 종류 | 기판 Size | 기판 Type | 기판 두께 | |||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Si | Ⅲ-Ⅴ | Glass | 조각 | 2” | 4” | 6” | 8” | 12” | 플랫 | 노치 | Standard | Special |
| 1T | ||||||||||||
공정(process)명
ICP etcher I (@KANC)
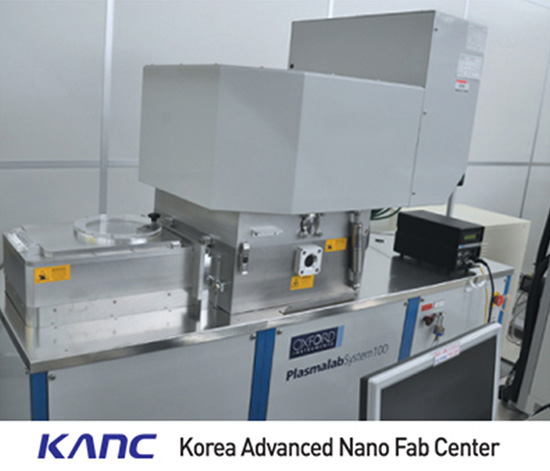
| 모델명 | ICP etcher I(양자팹) (ICP 380 System 100) | ||
|---|---|---|---|
| Maker | OXFORD SYSTEM | 담당자 | 임웅선 |
| 연락처 | 031-546-6235 | woongsun.lin@kanc.re.kr | |
| 상태 | KANC에서 서비스 | ||
| 장비 사양 |
|
||
| 공정 성능 |
|
||
○ (가능) / △ (협의 필요) / X (불가)
| 기판 종류 | 기판 Size | 기판 Type | 기판 두께 | |||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Si | Ⅲ-Ⅴ | Glass | 조각 | 2” | 4” | 6” | 8” | 12” | 플랫 | 노치 | Standard | Special |
공정(process)명
ICP etcher II (@KANC)
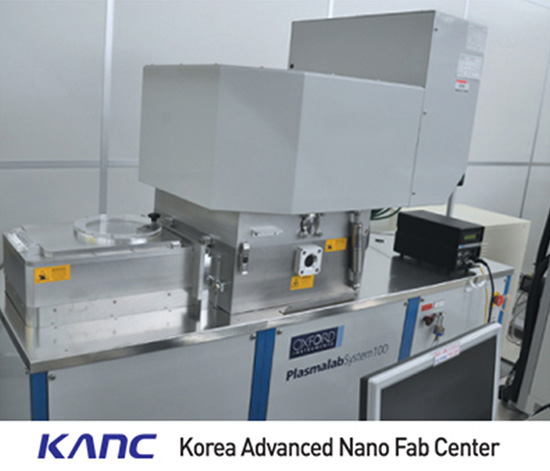
| 모델명 | ICP etcher II(양자팹) (ICP 380 System 100) | ||
|---|---|---|---|
| Maker | OXFORD SYSTEM | 담당자 | 임웅선 |
| 연락처 | 031-546-6235 | woongsun.lin@kanc.re.kr | |
| 상태 | KANC에서 서비스 | ||
| 장비 사양 |
|
||
| 공정 성능 |
|
||
○ (가능) / △ (협의 필요) / X (불가)
| 기판 종류 | 기판 Size | 기판 Type | 기판 두께 | |||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Si | Ⅲ-Ⅴ | Glass | 조각 | 2” | 4” | 6” | 8” | 12” | 플랫 | 노치 | Standard | Special |
공정(process)명
저선량 이온빔 주입장치(@KAERI)

| 모델명 | 저선량 이온빔 주입장치 | ||
|---|---|---|---|
| Maker | _ | 담당자 | 석재권 |
| 연락처 | 054-750-5307 | jksuk@kaeri.re.kr | |
| 상태 | KAERI에서 서비스 | ||
| 장비 사양 & 공정 성능 |
|
||
○ (가능) / △ (협의 필요) / X (불가)
| 기판 종류 | 기판 Size | 기판 Type | 기판 두께 | |||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Si | Ⅲ-Ⅴ | Glass | 조각 | 2” | 4” | 6” | 8” | 12” | 플랫 | 노치 | Standard | Special |
공정(process)명
E-beam lithography 2 (@KANC)

| 모델명 | JBX8100FS | ||
|---|---|---|---|
| Maker | JEOL | 담당자 | 김창환 |
| 연락처 | 031-546-6336 | changhwan.kim@kanc.re.kr | |
| 상태 | KANC에서 서비스 | ||
| 장비 사양 |
|
||
| 공정 성능 |
|
||
○ (가능) / △ (협의 필요) / X (불가)
| 기판 종류 | 기판 Size | 기판 Type | 기판 두께 | |||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Si | Ⅲ-Ⅴ | Glass | 조각 | 2” | 4” | 6” | 8” | 12” | 플랫 | 노치 | Standard | Special |
